在“超越摩爾”(More than Moore)時代,先進封裝技術(shù)已成為驅(qū)動半導(dǎo)體性能持續(xù)攀升的核心引擎。隨著異質(zhì)集成、2.5D/3D堆疊及混合鍵合(Hybrid Bonding)等前沿工藝的廣泛應(yīng)用,封裝結(jié)構(gòu)日趨復(fù)雜,互連間距正向微米甚至亞微米級跨越。然而,工藝復(fù)雜度的指數(shù)級提升也帶來了嚴峻的檢測挑戰(zhàn):如何在不破壞結(jié)構(gòu)的前提下,實現(xiàn)跨層級、高精度的內(nèi)部缺陷捕捉,已成為關(guān)乎良率控制與成本優(yōu)化的關(guān)鍵瓶頸。
一,先進封裝的檢測痛點
現(xiàn)代先進封裝集成了多芯片堆疊、硅通孔(TSV)、微凸點(Micro-bump)等極細微結(jié)構(gòu),其檢測難點主要體現(xiàn)在:
①缺陷隱匿化:空洞、分層、微裂紋等關(guān)鍵缺陷往往深埋于多層材料內(nèi)部,令傳統(tǒng)光學(xué)手段難以觸達。
②材料穿透需求:需在不損傷敏感電路的前提下,實現(xiàn)對硅基底、陶瓷及聚合物等多種不透明材料的深度穿透成像。
③精度與產(chǎn)能的平衡:既需捕捉微米級細微缺陷,又需滿足量產(chǎn)環(huán)境下大面積、高通量的快速掃描需求。
④界面狀態(tài)可視化:銅-銅(Cu-Cu)鍵合界面的質(zhì)量、介質(zhì)層粘接的均勻性等,直接決定了器件的電性能與長期可靠性。
二,傳統(tǒng)檢測方法的局限性
目前主流檢測手段在應(yīng)對3D集成等新興結(jié)構(gòu)時,局限性日益凸顯:

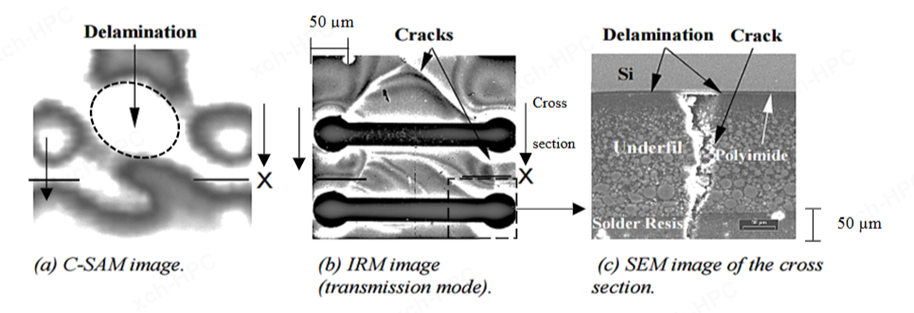
C-SAM、IR、SEM對比圖
三,SWIR成像技術(shù):突破性的物理飛躍
短波紅外(SWIR)通常指波長在900 nm-1700 nm的電磁波,基于獨特的物理特性,SWIR正成為先進封裝檢測的變革性利器:
①卓越的硅穿透能力:硅材料在SWIR波段具有良好的透光性,允許光子穿透基板,實現(xiàn)對背面金屬層、TSV及鍵合界面的非破壞性視覺檢測。
②高對比度材料區(qū)分:銅、硅、氧化物及聚合物在SWIR波段的光學(xué)特征差異顯著,能夠清晰勾勒出微米級的內(nèi)部缺陷輪廓。
③無損非接觸檢測:作為非電離輻射成像,SWIR對器件無物理或電學(xué)損傷,完美適配在線(In-line)及在片(On-wafer)檢測場景。
④高效全場掃描:配合高靈敏度銦鎵砷(InGaAs)相機,可實現(xiàn)高速、大畫幅成像,從而嚴絲合縫地嵌入量產(chǎn)節(jié)拍。
四,SWIR在先進封裝中的典型應(yīng)用場景
①混合鍵合(Hybrid Bonding)質(zhì)量評估:直接觀測銅凸點對齊度與介質(zhì)層鍵合完整性,識別微空洞及污染,為工藝調(diào)優(yōu)提供即時反饋。
②TSV與硅內(nèi)互連可視化:穿透硅襯底監(jiān)控TSV填充質(zhì)量及內(nèi)部裂紋,評估3D堆疊結(jié)構(gòu)的機械穩(wěn)定性。
③背面工藝(Backside Processing)監(jiān)控:指在減薄、背面金屬化工藝后,對劃痕、殘余應(yīng)力及層間套刻精度進行的非破壞性檢查。
④鍵合能量(Bonding Energy)定量分析:在W2W(晶圓對晶圓)場景下,利用SWIR測量裂紋長度(Crack Length),結(jié)合Maszara模型精確計算鍵合能,量化評估鍵合強度。
⑤高精度紅外對準:在鍵合過程中,利用SWIR實現(xiàn)亞微米級的跨材料層對準,顯著提升封裝良率。

近紅外成像效果圖
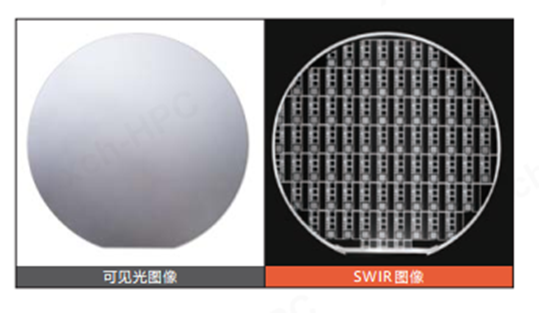
空間光 vs SWIR成像效果
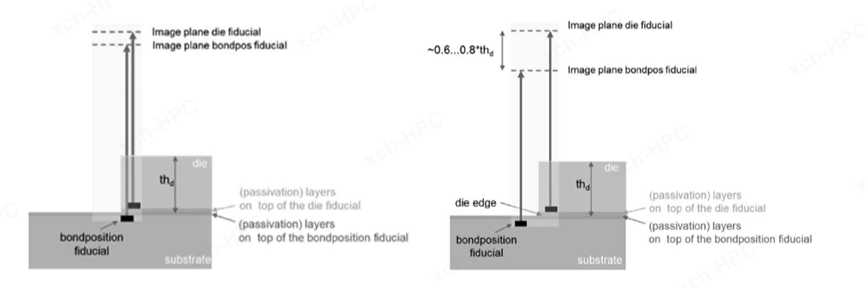
近紅外成像對準原理
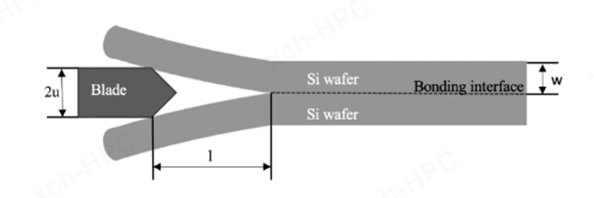
晶圓鍵合界面結(jié)合強度的測試方法示意圖(雙懸臂梁DCB實驗)
五,選型策略:線掃(Line Scan)與面陣(Area Scan)的博弈
在實際部署中,選擇何種成像模式往往取決于檢測環(huán)節(jié)在生產(chǎn)流片中的定位。
1,線掃相機:作為量產(chǎn)全檢的“競速者”,線掃相機通過與晶圓間的連續(xù)相對運動成像,專為追求極致效率的量產(chǎn)環(huán)境而生。
①工藝契合度:完美適配12寸晶圓的全表面缺陷篩查。在減薄、拋光后,能以極高通量捕捉深埋內(nèi)部的微裂紋與異物。
②技術(shù)優(yōu)勢:
吞吐量(Throughput)最大化:消除頻繁的“啟-停”等待,實現(xiàn)近乎實時的在線檢測。
圖像一致性:能有效規(guī)避大面積成像時的邊緣畸變,實現(xiàn)無縫的圖像拼接,從而利于算法進行全局比對。
③核心挑戰(zhàn):對運動平臺的同步精度(Jitter)及線光源的均勻性有極嚴苛要求。
2,面陣相機:精微對準與復(fù)核的“定格者”,面陣相機通過瞬時曝光捕捉高分辨率局部特征,更傾向于靜態(tài)或準靜態(tài)下的精密分析。
①工藝契合度:專注于混合鍵合中的亞微米級紅外對準(Alignment),以及對缺陷點的二次高倍率復(fù)檢。
②技術(shù)優(yōu)勢:
靜態(tài)分辨率極限:配合高倍率顯微系統(tǒng),能清晰呈現(xiàn)銅柱連接或TSV填充的細微細節(jié)。
系統(tǒng)集成簡易:光學(xué)調(diào)試與照明方案更具普適性,適合部署在空間受限或運動路徑復(fù)雜的設(shè)備內(nèi)部。
③核心挑戰(zhàn):大面積掃描時,頻繁的“步進-掃描”循環(huán)會顯著犧牲產(chǎn)能(UPH)。

若您的目標是“全量篩查、提升良率與UPH”,線掃系統(tǒng)是確保產(chǎn)線節(jié)奏不中斷的最優(yōu)解;若您的目標是“極致對準、工藝調(diào)優(yōu)”,則面陣系統(tǒng)在精度與穩(wěn)定性方面更勝一籌。

濱松SWIR相機產(chǎn)品
 鄂公網(wǎng)安備 42011502001385號 鄂ICP備2021012849號
鄂公網(wǎng)安備 42011502001385號 鄂ICP備2021012849號